

• High-density HDI fine pitch substrate
• Advanced bonding process
• Mature technology and low cost
WBBGA (Wire Bond Ball Grid Array, wire bond chip ball grid array) is a traditional and mature packaging process, and its characteristics and applications are as follows:
Technical characteristics
Accommodate more pins and enhance signal integration: The WBBGA package uses a ball-gate array method to create array solder balls at the bottom of the package body substrate as the I/O terminals of the circuit and interconnect with the printed circuit board (PCB), which can accommodate more pins and thereby improve signal integration.
Coplanar soldering assembly enhances reliability: The adoption of the coplanar soldering assembly method significantly improves the reliability of WBBGA packaging. This soldering method can ensure good contact between the solder balls and the PCB, reducing faults caused by poor contact.
Adaptable to various circuit performance requirements: The WBBGA package is suitable for complex analog circuits and RF circuits, and can meet various circuit performance requirements. In analog circuits, to make full use of the chip area, the layout is often designed manually. However, the WBBGA package can provide sufficient pins and good electrical performance to meet this requirement. In RF circuits, the WBBGA package can support large-sized inductors, thereby meeting the requirements of RF circuits for inductors.

• Application: 800G Optical communication
• Layers: 12L
• Min hole size: 60μm
• Core material: ABF low Dk/Df
• L/S: 15/15μm
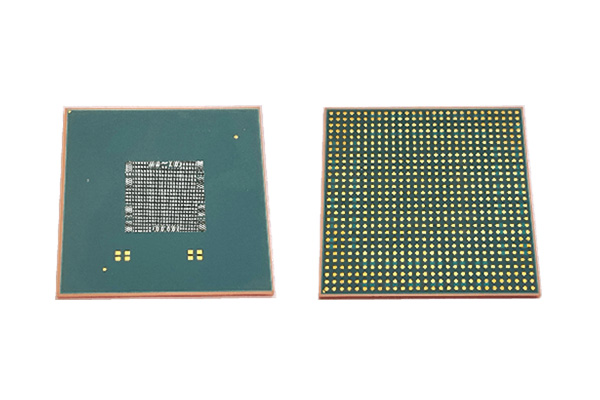
• Application: GPU
• Layers: 10L
• Min hole size: 60μm
• Core material: ABF low Dk/Df
• L/S: 15/15μm

• Product type: FCCSP for memory
• Layers: 4L
• Min. hole size: 80μm
• Core material: ultra low CTE and high TG
• Min. L/S: 20/20μm
Reach out to us via chat, phone, or our simple contact form.
Get a FREE Quote Today
Our business scope includes IC substrate design and simulation, IC substrate manufacturing, IC packaging and testing, as well as comprehensive hardware assembly services(PCB & PCBA).